Multi-layer AMB substrates with advanced multi-layer structures are designed for high-performance electric vehicle power modules.
This cutting-edge technology enhances power efficiency and heat dissipation by integrating Cu-Block connections with Via Technology, utilizing an insulating ceramic substrate for optimal thermal and electrical performance.
Via Connection Solutions
Optimizing Electrothermal Performance with Via Technology in Insulating Ceramic Substrates

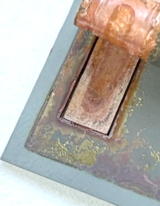
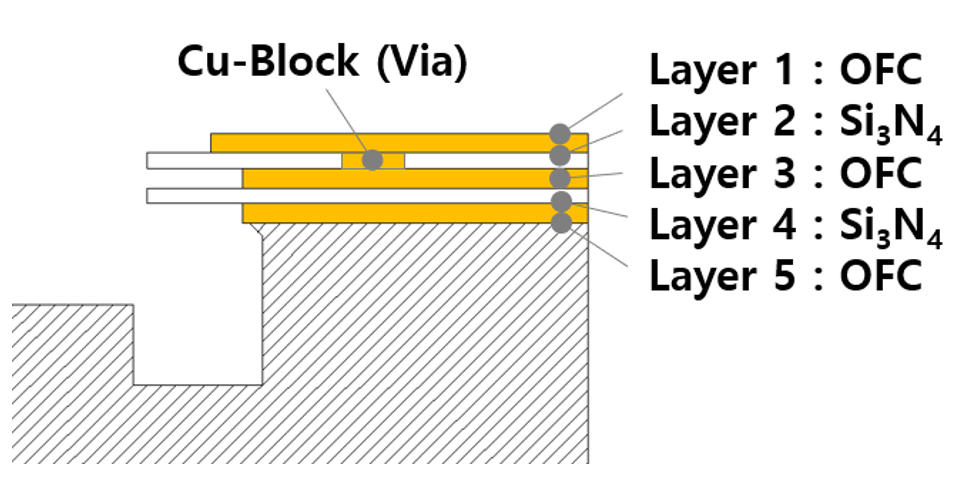
Wireless AMB-Substrate for DSC
Si₃N₄ AMB Substrate with integrated spacer:
this technology is used for power modules with cooling on both sides, also known as “Dual-Side Cooling”(DSC).
With this construction technique, a very large heat dissipation can be realized and the reliability of SiC and GaN semiconductors will be dramatically increased.
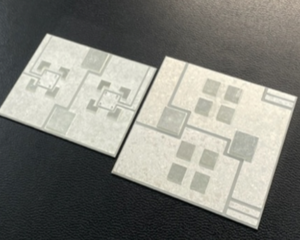
Integrated Heat Sink on AMB Substrate
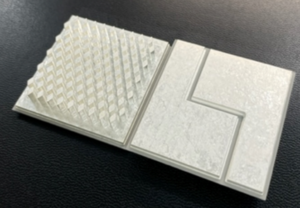
Integrated heat sink on AMB:
In order to meet the challenges of the next generation power modules with higher junction temperatures, we can offer you Si₃N₄ AMB substrates with an integrated heat sink with up to 2mm thick copper on the circuit layer.